消息称三星和 SK 海力士改进 HBM 封装工艺,即将量产 12 层产品
IT之家 9 月 12 日消息,根据韩国 The Elec 报道,三星电子和 SK 海力士两家公司加速推进 12 层 HBM 内存量产。生成式 AI 的爆火带动英伟达加速卡的需求之外,也带动了对高容量存储器(HBM)的需求。HBM 堆叠的层数越多,处理数据的能力就越强,目前主流 HBM 堆叠 8 层,而下一代 12 层也即将开始量产。

报道称 HBM 堆叠目前主要使用正使用热压粘合(TCB)和批量回流焊(MR)工艺,而最新消息称三星和 SK 海力士正在推进名为混合键合(Hybrid Bonding)的封装工艺,突破 TCB 和 MR 的发热、封装高度等限制。
Hybrid Bonding 中的 Hybrid 是指除了在室温下凹陷下去的铜 bump 完成键合,两个 Chip 面对面的其它非导电部分也要贴合。因此,Hybrid Bonding 在芯粒与芯粒或者 wafer 与 wafer 之间是没有空隙的,不需要用环氧树脂进行填充。
IT之家援引该媒体报道,三星电子和 SK 海力士等主要公司已经克服这些挑战,扩展了 TCB 和 MR 工艺,实现最高 12 层。
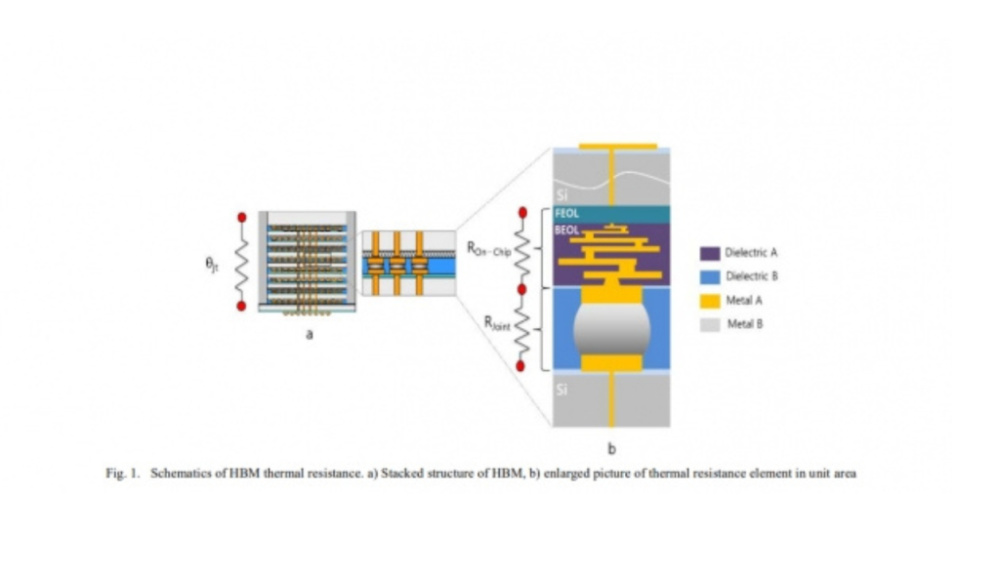
报道称采用 Hybrid Bonding 工艺之后,显著提高了输入 / 输出(IO)吞吐量,允许在 1 平方毫米的面积内连接 1 万到 10 万个通孔(via)。
免责声明:凡本网站发布的文章、图片、音频、视频等内容所表述的观点和立场不代表本网站的观点和立场,若对该观点或立场有疑义或异议,请及时用电子邮件或电话通知我们,以迅速采取适当措施,避免给双方造成不必要的经济损失。凡本网站发布的所有文章 、图片、音频、视频文件等资料的版权归版权所有人所有,本站采用的非本站原创文章及图片等内容无法一一和版权者联系,如果本网所选内容的文章作者及编辑认为其作品不宜上网供大家浏览,或不应无偿使用,请及时用电子邮件或电话通知我们,以迅速采取适当措施,避免给双方造成不必要的经济损失。
相关阅读
韬天下 | 酱香型、浓香型、清香型白酒的区别?
2023.10.19
高端酱香白酒怎么选?肆拾玖坊孔雀令,青花郎品质够实在!
2023.10.19
一群70后聚会晒“白酒”走红网络,网友:都是一代人的记忆
2023.10.19
国凌酱酒分享酱香型白酒的54个知识点
2023.10.19
白酒挑选指南,肆拾玖坊宗师酒、水井坊井台如何抉择
2023.10.19
三星计划明年初量产超过300层的第九代V-NAND闪存
2023.10.19












